PCB已发展数十年, 2006年时因应电子产品组装导入无铅制程生产( Lead Free Process)后,把回焊( Reflow Soldering)与波焊( Wave Soldering)组装温度提高,而所增加的热应力对传统PCB潜在的影响更深远,故导致系统产品失效( Defect)的案例,也较转换无铅制程前更为严重;虽然许多材料供货商为克服热应力( Thermal Stress)问题而开发出了High Tg基材或改善填充剂( Filler)种类,但也因此而衍生出许多其他问题,如焊垫强度( Bond Pad Strength)降低、钻孔质量不佳以及阳极细丝导通( Conductive Anode Filament,简称CAF)等状况。因此PCB的可靠度(Reliability)试验,再度受到高度重视。
继无铅制程导入后产生的问题外,目前各国际组织亦积极推动产品无卤化( Halogen Free)材料, 以响应环保。在双重要求下,PCB厂商必须符合无铅制程规格,同时也得达到无卤素含量要求,鉴于此一情况,德凯宜特秉持着伙伴精神,开发出一套针对PCB材料特性的可靠度验证方法,可协助客户产品进行前期的可靠度验证或产品量产后的固定抽样分析。
无卤素PCB之服务项目
- 温度循环试验及动态低阻试验

<IPC-TM-650 2.6.6 建议条件>
- 湿式与干式温度冲击试验
TST试验可分为液槽式与气槽式两类,均为双槽模式。所谓的双槽系指冷槽与热槽分开,透过样品之移动达到驻留,此驻留时间包含转移时间,待测样品必须于两分钟内达到要求之试验温度。依据IPC-TM-650 2.6.7中建议试验条件,FR4材料使用condition D,而FR5材料使用condition E,总试验循环数依IPC规范建议至少100 cycles。对于本试验用之PCB,可采用雏菊链(Daisy Chain)设计,亦可采用实际产品板进行试验。使用Daisy Chain设计,有助于减少样品数量并可观察到较完整的现象,对于新供货商之验证上更有帮助。

<IPC-TM-650 2.6.7 建议条件>
- 离子迁移试验
ECM主要是透过金属解离后游离至另一极性,并产生金属沉积造成的dendrite导致短路,或透过生成金属化合物游离透过PCB内层延长至另一导通点,两者之差异主要为反应方程式的不同,发生的位置可分为PCB表面与内部。发生于表面时,其试验方法称为表面绝缘电阻试验( Surface Insulation Resistance,简称SIR);发生于表面与内部间或者内部与内部时,则称为阳极细丝导通( Conductive Anode Filament,简称CAF)。 对于本试验用之PCB,一般采用梳型电路(comb design)设计,亦可采用实际产品板进行试验。使用梳型电路设计,有助于减少样品数量并可观察到较完整的现象,对于新供货商之验证上更有帮助。
无卤素材料的CAF试验结果普遍较传统FR4材料或High Tg FR4来得差,主要因素为材料本身的特性以及其对PCB压合,钻孔制程质量影响甚大,造成CAF的风险更加严重。

<即時監控電阻值變化>
- 焊垫结合强度试验
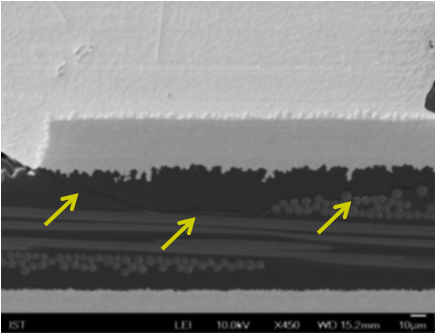
<板材变更后常见的焊垫抗裂的现象>
而IPC-9708因此孕育而生,但此项试验并无允收规格,常是以样品测试值的标准偏差或者Cpk来观察质量稳定度,亦可藉由历史资料比对结果。对于无卤素材料来说,文献纪录均以传统的Peeling Test作为观察,认为其接合强度较典型FR4差。然而,从焊盘强度测试中观察到的测试结果与剥离测试没有正相关。

<IPC-9708三种评估焊垫坑裂的方式>
- 耐热模拟试验

<IPC-TM-650 2.6.27 回焊模拟测试建议条件>
- CTE与Tg量测
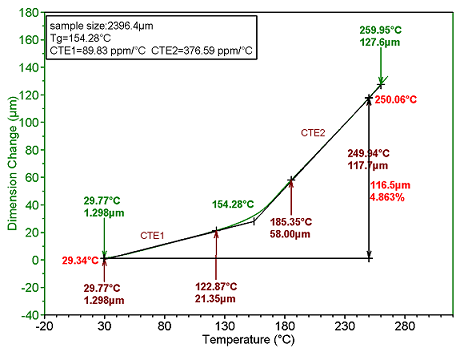
<热膨胀系数(Coefficient of Thermal Expansion)>
- 弯曲试验
以携带型产品而言,常用的弯曲试验为Cyclic Bending,目的是为了仿真产品使用时受到弯曲应力持续作用下,造成材料的疲劳问题。另外,对于此PCB可搭配零件同时进行,可观察PCB于受外力时,因本身所产生的应变( Strain)对于零件焊点的影像,典型的问题如Pad Peeling或者Pad Cratering等现象均可由此方法呈现。此外,利用单次持续弯曲,可看出因无卤板材硬度高,透过Daisy Chain监控下,在相同的弯曲程度下,其所发生的不良数量较传统使用的high Tg FR4明显高了许多。

<无卤PCB与FR-4弯曲试验比较>
- 机械冲击试验
- 故障分析
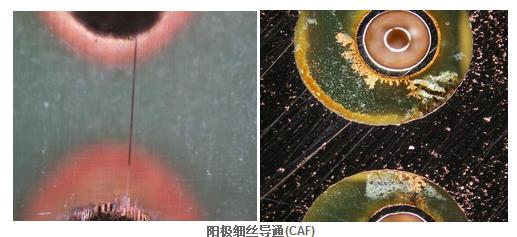
<阳极细丝导通(CAF)>
本公司目前对于PCB靠度试验,依据IPC-TM-650 主要类别,区分为化学性试验、机械应力试验、环境/可靠度试验与SMT组装模拟等,除可协助客户进行一系列的试验外,并提供相关技术咨询与故障分析服务。

德凯宜特顾问团队提供专业咨询,让所有在产品验证上遇到的问题都能迎刃而解 PROBLEM SOLVED!
如需更深入的相关信息或服务,欢迎来信至咨询信箱 📧 sos@dekra-ist.com




